解决方案
SOLUTION

时间: 2024-09-25
浏览量: 4627
CoventorWare可由工艺和二维版图直接生成三维实体模型。这样的设计方式与实际MEMS器件的制造过程一致,简化了建模过程。
本文通过由三个单轴微镜组成的阵列来呈现CoventorWare基于工艺和二维版图的建模过程。该器件的SEM图如下图所示。
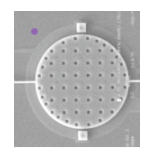
图1 案例器件SEM示意图
1.1创建材料属性库
在材料属性编辑器中创建器件所需的材料属性库。
1.2创建工艺流程
在CoventorWare的工艺编辑器中可根据实际制造过程创建工艺流程。
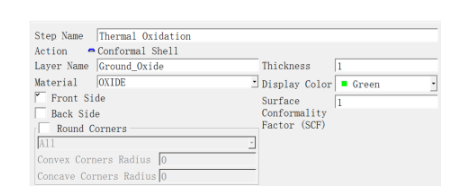
1.2.1热氧
在50um厚的Silicon_100基底上热氧,1um。在工艺编辑器中采用Conformal Shell选项创建该工序步。
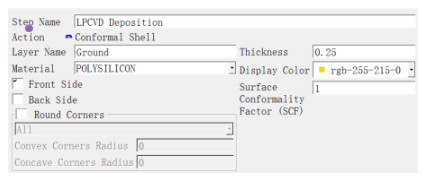
图2 热氧
1.2.2LPCVD沉积
低压化学气相沉积多晶硅层,0.25um。在工艺编辑器中采用Conformal Shell选项创建该工序步。

图3 沉积多晶硅
1.2.3RIE刻蚀多晶硅
反应离子刻蚀多晶硅。在工艺编辑器中采用Straight Cut创建该工序步。该步刻蚀采用名字为GROUND的掩模版。
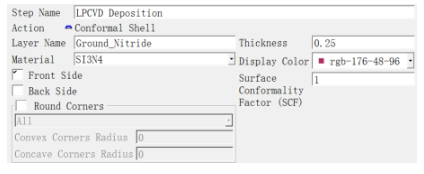
图4 RIE刻蚀多晶硅
1.2.4LPCVD沉积
低压化学气相沉积氮化硅,0.25um。在工艺编辑器中采用Conformal Shell选项创建该工序步。
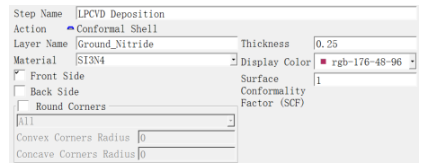
图5 沉积氮化硅
1.2.5LPCVD沉积
低压化学气相沉积多晶硅,0.25um。在工艺编辑器中采用Conformal Shell选项创建该工序步。
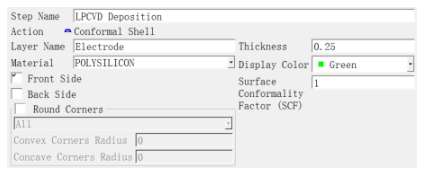
图6 沉积多晶硅
1.2.6RIE刻蚀多晶硅
反应离子刻蚀多晶硅。在工艺编辑器中采用Straight Cut创建该工序步。该步刻蚀采用名字为ELECTRODE的掩模版。
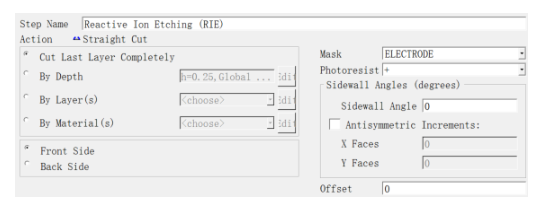
图7 RIE刻蚀多晶硅
1.2.7LPCVD沉积
低压化学气相沉积PSG,2um,作为牺牲层。在工艺编辑器中采用Planar Fill选项创建该工序步。

图8 沉积PSG
1.2.8RIE刻蚀
反应离子刻蚀PSG。在工艺编辑器中采用Straight Cut创建该工序步,刻蚀深度0.5um。该步刻蚀采用名字为BUMPS的掩模版。

图9 刻蚀PSG
1.2.9RIE刻蚀
反应离子刻蚀PSG。在工艺编辑器中采用Straight Cut创建该工序步。该步刻蚀采用名字为ANCHOR的掩模版。
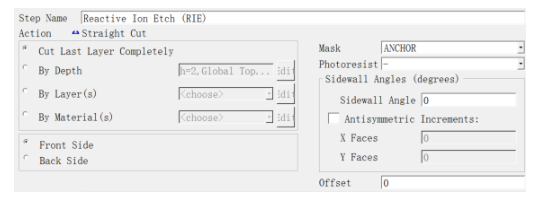
图10 PSG二次刻蚀
1.2.10LPCVD沉积
低压化学气相沉积多晶硅,4um。在工艺编辑器中采用Conformal Shell选项创建该工序步。

图11 沉积多晶硅
1.2.11溅射
溅射金属,GOLD,0.2um。在工艺编辑器中采用Conformal Shell选项创建该工序步。
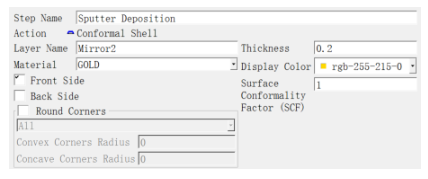
图12 溅射金属
1.2.12RIE刻蚀
反应离子刻蚀。在工艺编辑器中采用Straight Cut创建该工序步,刻蚀深度5um。该步刻蚀采用名字为MIRROR的掩模版。
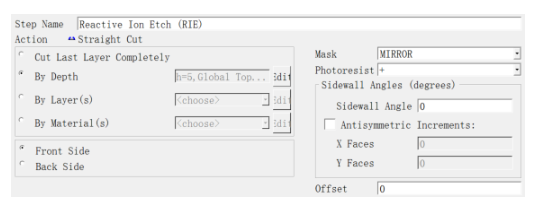
图13 刻蚀形成镜面
1.2.13RIE刻蚀
反应离子刻蚀。在工艺编辑器中采用Straight Cut创建该工序步,刻蚀深度5um。该步刻蚀采用名字为HOLE的掩模版。
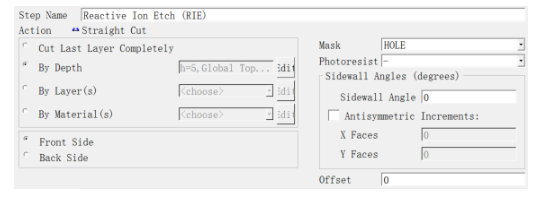
图14 刻蚀镜面通孔
1.2.14释放牺牲层
释放牺牲层PSG。在工艺编辑器中采用Delete创建该工序步。

图15 释放牺牲层
1.2.15蒸镀
蒸镀金属,铝,0.5um。在工艺编辑器中采用Conformal Shell选项创建该工序步。
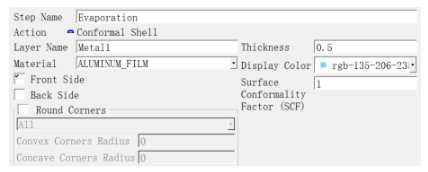
图16 蒸镀铝
1.2.16干法刻蚀
干法刻蚀金属铝。在工艺编辑器中采用Straight Cut创建该工序步。该步刻蚀采用名字为METAL1的掩模版。

图17 刻蚀铝
到此该器件的工艺流程编写完成,如下图所示。
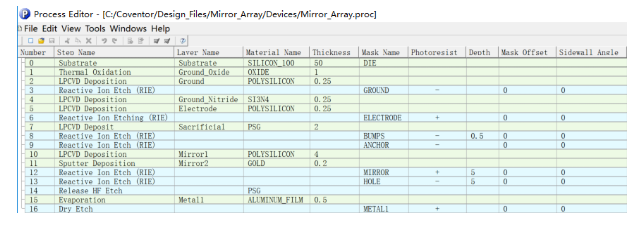
图18 工艺流程
1.2.17工艺流程图示
为了便于直观显示制造过程,利用CoventorWare Clip Device with Mask功能分步显示每步刻蚀工序,如下图所示。
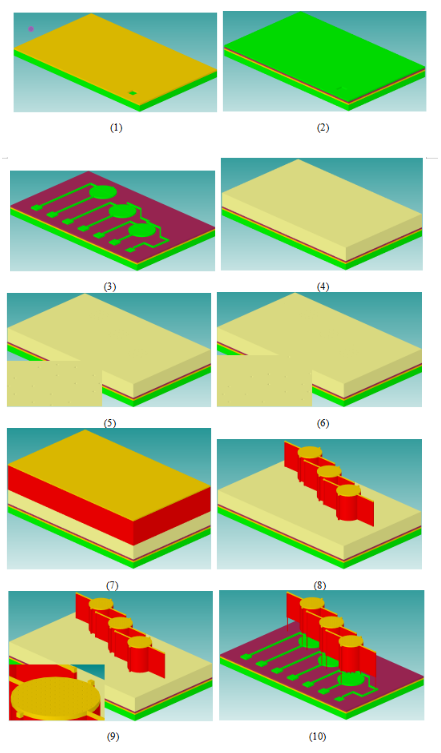
图19 三维显示制造过程